
คำอธิบาย
เครื่อง SMD ซ่อมมือถืออัตโนมัติ
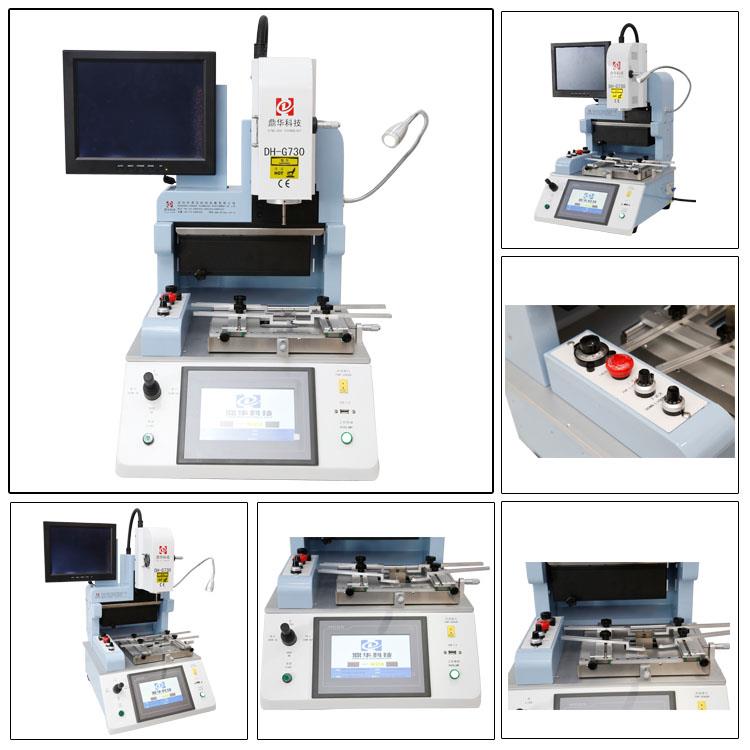

1. การประยุกต์ใช้กล้อง CCD มือถือซ่อมเครื่อง SMD
เหมาะอย่างยิ่งสําหรับการซ่อมเมนบอร์ดโทรศัพท์มือถือและเมนบอร์ดขนาดเล็ก เหมาะสําหรับชิปชนิดต่าง ๆ : BGA, PGA, POP, BQFP, QFN, SOT223, PLCC, TQFP, TDFN, TSOP, PBGA, CPGA, ชิป LED
2.คุณลักษณะของผลิตภัณฑ์ของเครื่อง SMD ซ่อมมือถืออัตโนมัติ
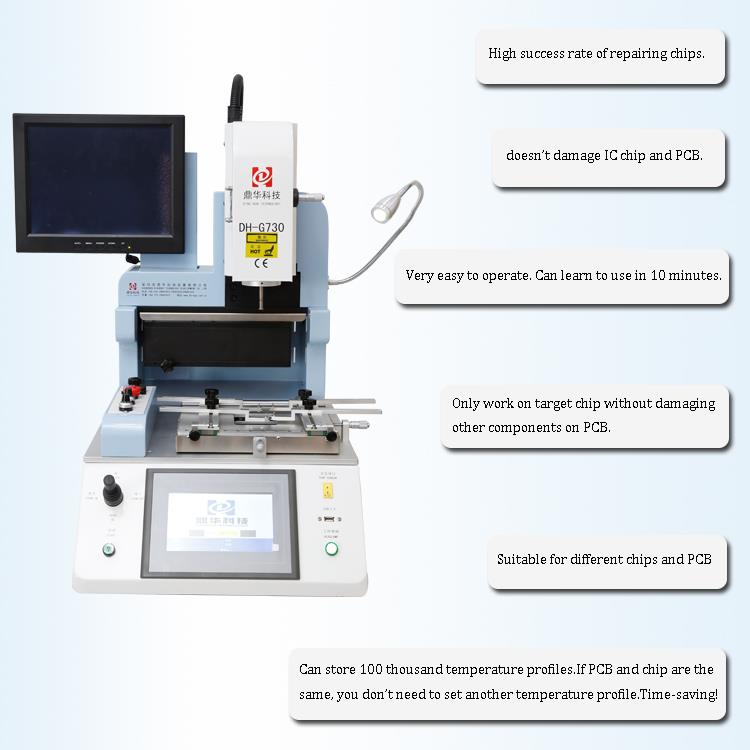
•ใช้กันอย่างแพร่หลายในการซ่อมระดับชิปในโทรศัพท์มือถือบอร์ดควบคุมขนาดเล็กหรือเมนบอร์ดขนาดเล็กเป็นต้น
•การเลิกใช้การติดตั้งและการบัดกรีโดยอัตโนมัติ
•ระบบการจัดตําแหน่งแสง HD CCD สําหรับการติดตั้ง BGA และส่วนประกอบอย่างแม่นยํา
•ฟิกซ์เจอร์สากลที่เคลื่อนย้ายได้ช่วยป้องกัน pcb จากความเสียหายบนส่วนประกอบขอบเหมาะสําหรับการซ่อมแซม pcb ทุกชนิด
•ไฟ LED กําลังสูงเพื่อให้แน่ใจว่ามีความสว่างสําหรับการทํางานและขนาดที่แตกต่างกันของหัวฉีดแม่เหล็กวัสดุโลหะผสมไททาเนียมเปลี่ยนและติดตั้งง่ายไม่เคยเปลี่ยนรูปและเป็นสนิม
3.ข้อกําหนดของหน้าจอสัมผัส MCGS มือถือซ่อมเครื่อง SMD

4.รายละเอียดของเครื่องซ่อมมือถือลมร้อน SMD
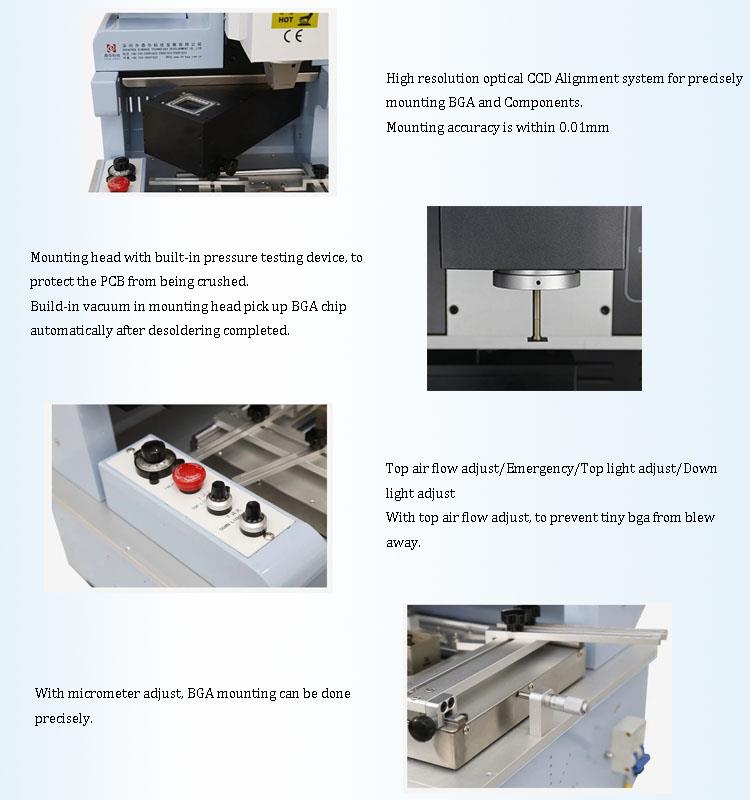

5.ทําไมเลือกของเราเครื่อง SMD ซ่อมมือถืออัตโนมัติ?


6.ใบรับรองของการจัดตําแหน่งแสงมือถือซ่อมเครื่อง SMD

7.บรรจุและการจัดส่งของซ่อมมือถืออัตโนมัติ SMD เครื่องแยกวิสัยทัศน์

8.การจัดส่งของเครื่อง SMD ซ่อมมือถืออัตโนมัติ
เราจัดส่งเครื่องผ่าน DHL / TNT / UPS / FEDEX ซึ่งรวดเร็วและปลอดภัย หากคุณต้องการเงื่อนไขการจัดส่งอื่น ๆ โปรดแจ้งให้เราทราบ
9. เงื่อนไขการชําระเงิน
โอนเงินผ่านธนาคาร, เวสเทิร์นยูเนี่ยน, บัตรเครดิต
เราจะส่งเครื่องกับ 5-10 ธุรกิจหลังจากได้รับการชําระเงิน
10.ความรู้ที่เกี่ยวข้อง
ผลของชั้นเคลือบผิว (ชุบ) ของ PCB ในการออกแบบ:
ในปัจจุบันวิธีการรักษาพื้นผิวแบบดั้งเดิมที่ใช้กันอย่างแพร่หลายคือดีบุกสเปรย์ชุบทอง OSP ชุบทอง
เราสามารถเปรียบเทียบข้อดีและข้อเสียของต้นทุนความสามารถในการเชื่อมความต้านทานการสึกหรอความต้านทานการเกิดออกซิเดชันและกระบวนการผลิตการเจาะและการปรับเปลี่ยนวงจร
กระบวนการ OSP: ต้นทุนต่ําการนําไฟฟ้าที่ดีและความเรียบ แต่ความต้านทานการเกิดออกซิเดชันไม่ดีไม่เอื้อต่อการเก็บรักษา การชดเชยการเจาะมักจะทําตาม 0.1 มม. และความกว้างของเส้นหนาทองแดง HOZ จะได้รับการชดเชย 0.025 มม. เมื่อพิจารณาถึงการเกิดออกซิเดชันและการปัดฝุ่นที่ง่ายมากกระบวนการ OSP จะเสร็จสมบูรณ์หลังจากการทําความสะอาดขึ้นรูป เมื่อขนาดชิ้นเดียวน้อยกว่า 80 มม. จะต้องพิจารณารูปแบบชิ้น การส่ง
กระบวนการชุบนิกเกิลโกลด์ด้วยไฟฟ้า: ความต้านทานการเกิดออกซิเดชันที่ดีและความต้านทานการสึกหรอ เมื่อใช้สําหรับปลั๊กหรือจุดสัมผัสความหนาของชั้นทองจะมากกว่าหรือเท่ากับ 1.3um ความหนาของชั้นทองที่ใช้สําหรับการเชื่อมมักจะเป็น 0.05-0.1um แต่ความสามารถในการบัดกรีสัมพัทธ์ ยากจน การชดเชยการเจาะจะทําตาม 0.1 มม. และความกว้างของเส้นจะไม่ได้รับการชดเชย เมื่อแผ่นทองแดงทําจาก 1OZ หรือมากกว่าชั้นทองแดงใต้ชั้นทองพื้นผิวมีแนวโน้มที่จะทําให้เกิดการแกะสลักมากเกินไปและการยุบตัวลงเพื่อให้เกิดการบัดกรี การชุบทองต้องการความช่วยเหลือในปัจจุบัน กระบวนการชุบทองได้รับการออกแบบให้แกะสลักก่อนที่พื้นผิวจะสลักอย่างสมบูรณ์ หลังจากการแกะสลักกระบวนการถอดสลักจะลดลง นี่คือเหตุผลที่ความกว้างของเส้นไม่ได้รับการชดเชย
กระบวนการชุบนิกเกิลชุบทองไร้ไฟฟ้า (ทองแช่) : ความต้านทานการเกิดออกซิเดชันที่ดีเอนทาลปีที่ดีการเคลือบแบบแบนใช้กันอย่างแพร่หลายในบอร์ด SMT การชดเชยการเจาะจะทําตาม 0.15 มม. ความกว้างของเส้นหนาทองแดง HOZ ได้รับการชดเชย 0.025 มม. เนื่องจากกระบวนการแช่ทองได้รับการออกแบบใน หลังจากหน้ากากบัดกรีจําเป็นต้องมีการป้องกันความต้านทานการแกะสลักก่อนการแกะสลักและความต้านทานการแกะสลักจะต้องถูกลบออกหลังจากการแกะสลัก ดังนั้นการชดเชยความกว้างของเส้นจึงมากกว่าแผ่นชุบทองดังนั้นทองคําจึงถูกฝากไว้หลังจากบัดกรีต้านทานและเส้นส่วนใหญ่มีความครอบคลุมของหน้ากากประสานโดยไม่จําเป็นต้องจมทอง สําหรับพื้นที่ขนาดใหญ่ของผิวทองแดงปริมาณของเกลือทองคําที่บริโภคโดยแผ่นทองแช่จะต่ํากว่าแผ่นทองคําอย่างมีนัยสําคัญ
การฉีดพ่นแผ่นดีบุก (63 ดีบุก / 37 ตะกั่ว) กระบวนการ: ความต้านทานการเกิดออกซิเดชันความไวค่อนข้างดีที่สุดความเรียบไม่ดีการชดเชยการเจาะจะทําตาม 0.15 มม. การชดเชยความกว้างของเส้นความหนาของทองแดง HOZ คือ 0.025 มม. กระบวนการและการจมขั้นพื้นฐานอย่างสม่ําเสมอปัจจุบันเป็นประเภทที่พบมากที่สุดของการรักษาพื้นผิว
เนื่องจากคําสั่ง ROHS ของสหภาพยุโรปจึงปฏิเสธการใช้สารอันตรายหกชนิดที่มีตะกั่วปรอทแคดเมียมเฮกซะวาเลนต์โครเมียมเฮกซะวาเลนต์โพลีโบรมิเนตไดฟีนิลอีเทอร์ (PBDE) และโพลีโบรมีนไบฟีนิล (PBB) และการรักษาพื้นผิวได้แนะนําสเปรย์ดีบุกบริสุทธิ์ (ดีบุกทองแดง






