เครื่อง Reflow BGA Rework หน้าจอสัมผัส Reflow
1. การบัดกรี การบัดกรี และการติดตั้งชิป BGA IC อัตโนมัติ
2. เลนส์กล้อง CCD แบบออปติคัล: เปิด / พับ 90 องศา, HD 1080P
3. กำลังขยายของกล้อง: 1x - 220x
4. ความแม่นยำของตำแหน่ง: ±0.01 มม
คำอธิบาย
1. ข้อกำหนดของเครื่อง Reflow BGA Rework หน้าจอสัมผัส Reflow
| พลัง | 5300W |
| เครื่องทำความร้อนยอดนิยม | เครื่องทำลมร้อน 1200W |
| เครื่องทำความร้อนด้านล่าง | เครื่องทำลมร้อน 1200W.อินฟราเรด 2700W |
| แหล่งจ่ายไฟ | AC220V±10% 50/60Hz |
| มิติ | L530*W670*H790mm |
| การวางตำแหน่ง | รองรับ PCB ร่อง V และมีฟิกซ์เจอร์สากลภายนอก |
| การควบคุมอุณหภูมิ | เทอร์โมคัปเปิ้ลชนิด K, การควบคุมวงปิด, การทำความร้อนอิสระ |
| ความแม่นยำของอุณหภูมิ | ±2 องศา |
| ขนาดพีซีบี | สูงสุด 450*490 มม.ต่ำสุด 22*22 มม |
| การปรับแต่งโต๊ะทำงานแบบละเอียด | ±15 มม. เดินหน้า/ถอยหลัง ±15 มม. ขวา/ซ้าย |
| ชิปบีจีเอ | 80*80-1*1มม |
| ระยะห่างชิปขั้นต่ำ | 0.15 มม |
| เซ็นเซอร์อุณหภูมิ | 1 (ไม่จำเป็น) |
2. รายละเอียดของ Reflow Touch Screen BGA Rework Machine
กล้อง CCD (ระบบการจัดตำแหน่งแสงที่แม่นยำ);
จอแสดงผลดิจิตอล HD ;
ไมโครมิเตอร์ (ปรับมุมของชิป);
เครื่องทำความร้อนด้วยอากาศร้อน
อินเตอร์เฟซหน้าจอสัมผัส HD, การควบคุม PLC;
ไฟหน้าแบบ LED ;
การควบคุมจอยสติ๊ก
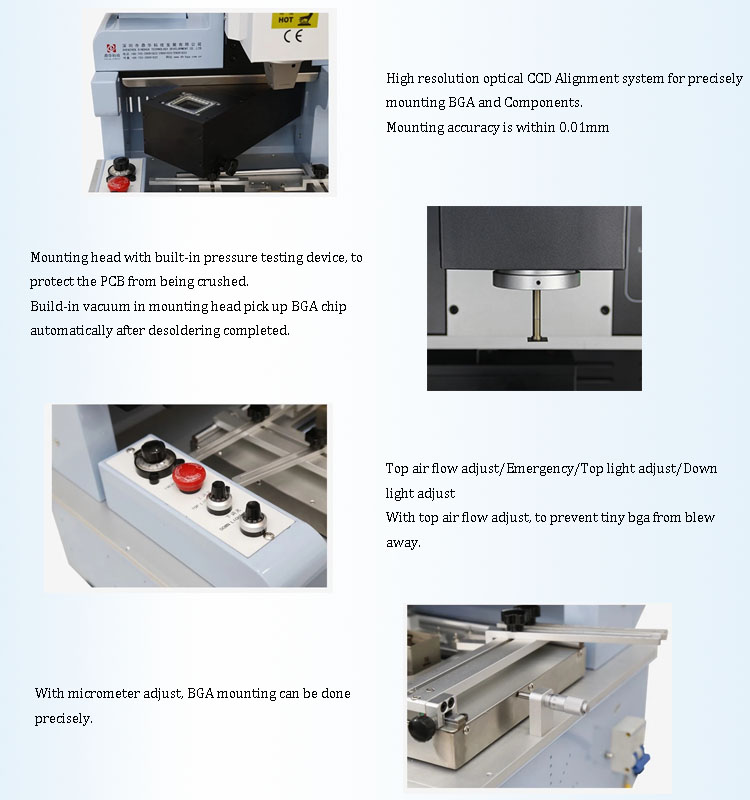

3. ทำไมต้องเลือกเครื่อง Reflow BGA Rework หน้าจอสัมผัส Reflow ของเรา?


4. ใบรับรองเครื่อง Rework BGA Reflow Touch Screen

5.การบรรจุและการจัดส่ง


ความรู้ที่เกี่ยวข้อง
แนวทางกระบวนการดำเนินการปรับปรุงชิป BGA
I. แนวทางกระบวนการซ่อมแซมชิป BGA
บทความนี้จะอธิบายขั้นตอนการดำเนินงานการบัดกรีและการวางลูกบอลสำหรับ BGA IC เป็นหลัก และข้อควรระวังเมื่อทำงานกับบอร์ดที่มีสารตะกั่วและไร้สารตะกั่วในสถานีปรับปรุง BGA
ครั้งที่สอง คำอธิบายกระบวนการซ่อมแซมชิป BGA
ควรคำนึงถึงปัญหาต่อไปนี้ในระหว่างการบำรุงรักษา BGA:
- เพื่อป้องกันความเสียหายจากอุณหภูมิที่สูงเกินในระหว่างกระบวนการบัดกรี ควรปรับอุณหภูมิของปืนลมร้อนล่วงหน้าก่อนใช้งาน ช่วงอุณหภูมิที่ต้องการคือ 280–320 องศา ไม่ควรปรับอุณหภูมิในระหว่างกระบวนการบัดกรี
- ป้องกันความเสียหายจากไฟฟ้าสถิตด้วยการสวมสายรัดข้อมือแบบไฟฟ้าสถิตก่อนหยิบจับส่วนประกอบ
- เพื่อหลีกเลี่ยงความเสียหายจากลมและแรงดันของปืนลมร้อน ให้ปรับแรงดันและแรงลมของปืนลมร้อนก่อนใช้งาน หลีกเลี่ยงการเคลื่อนย้ายปืนขณะทำการบัดกรี
- เพื่อป้องกันความเสียหายต่อแผ่น BGA บน PCBA ให้แตะ BGA ด้วยแหนบเบาๆ เพื่อตรวจสอบว่าบัดกรีละลายแล้วหรือไม่ หากสามารถถอดบัดกรีออกได้ ตรวจสอบให้แน่ใจว่าบัดกรีที่ยังไม่ละลายได้รับความร้อนจนละลาย หมายเหตุ: ใช้งานอย่างระมัดระวังและอย่าใช้แรงมากเกินไป
- ให้ความสนใจกับตำแหน่งและการวางแนวของ BGA บน PCBA เพื่อหลีกเลี่ยงการก่อตัวของลูกบอลบัดกรีรอง
III. อุปกรณ์และเครื่องมือพื้นฐานที่ใช้ในการบำรุงรักษา BGA
ต่อไปนี้เป็นอุปกรณ์และเครื่องมือพื้นฐานที่จำเป็น:
- ปืนลมร้อนอัจฉริยะ (ใช้สำหรับถอด BGA)
- โต๊ะบำรุงรักษาป้องกันไฟฟ้าสถิตและสายรัดข้อมือไฟฟ้าสถิต (สวมสายรัดข้อมือก่อนใช้งานและทำงานที่สถานีป้องกันไฟฟ้าสถิต)
- น้ำยาทำความสะอาดป้องกันไฟฟ้าสถิต (ใช้สำหรับทำความสะอาด BGA)
- สถานีปรับปรุง BGA (ใช้สำหรับการบัดกรี BGA)
- เตาอบอุณหภูมิสูง (สำหรับการอบบอร์ด PCBA)
อุปกรณ์เสริม: ปากกาดูดสูญญากาศ, แว่นขยาย (กล้องจุลทรรศน์)
IV. การเตรียมการอบก่อนบอร์ดและข้อกำหนดที่เกี่ยวข้อง
1.กระดานจะต้องใช้เวลาในการอบที่แตกต่างกันขึ้นอยู่กับเวลาในการเปิดรับแสง เวลาเปิดรับแสงขึ้นอยู่กับวันที่ประมวลผลบนบาร์โค้ดของบอร์ด
2.เวลาในการอบมีดังนี้:
- เวลาเปิดรับแสงน้อยกว่าหรือเท่ากับ 2 เดือน: เวลาอบ=10 ชั่วโมง อุณหภูมิ=105±5 องศา
- เวลาเปิดรับแสง > 2 เดือน: เวลาอบ=20 ชั่วโมง อุณหภูมิ=105±5 องศา
3.ก่อนอบบอร์ด ให้ถอดส่วนประกอบที่ไวต่ออุณหภูมิ เช่น ใยแก้วนำแสงหรือพลาสติกออก เพื่อป้องกันความเสียหายจากความร้อน
4. การทำงานซ้ำ BGA ทั้งหมดจะต้องเสร็จสิ้นภายใน 10 ชั่วโมงหลังจากถอดบอร์ดออกจากเตาอบ
5. หากไม่สามารถทำงานซ้ำ BGA ได้ภายใน 10 ชั่วโมง ให้เก็บ PCBA ไว้ในเตาอบแห้งเพื่อหลีกเลี่ยงการดูดซึมความชื้น การอุ่น PCBA ซ้ำอาจทำให้เกิดความเสียหายได้
V. ขั้นตอนการบัดกรีชิป BGA และการปลูกลูกบอล
1.การเตรียม BGA ก่อนการบัดกรี
ตั้งค่าพารามิเตอร์ปืนลมร้อนดังต่อไปนี้: อุณหภูมิ=280 องศา –320 องศา , เวลาในการบัดกรี=35–55 วินาที, การไหลเวียนของอากาศ=ระดับ 6 วาง PCBA บนโต๊ะป้องกันไฟฟ้าสถิต และรักษาความปลอดภัย
2. การบัดกรีชิป BGA
จำทิศทางและตำแหน่งของชิปก่อนที่จะถอดออก หากไม่มีซิลค์สกรีนหรือเครื่องหมายบน PCBA ให้ใช้มาร์กเกอร์เพื่อร่างพื้นที่เล็กๆ ที่ด้านล่างของ BGA ใช้ฟลักซ์เล็กน้อยใต้หรือรอบๆ BGA เลือกหัวเชื่อมพิเศษขนาด BGA ที่เหมาะสมสำหรับปืนลมร้อน จัดแนวด้ามจับปืนในแนวตั้งกับ BGA โดยเว้นระยะห่างระหว่างหัวฉีดกับตัวเครื่องประมาณ 4 มม. เปิดใช้งานปืนลมร้อน มันจะทำการบัดกรีโดยอัตโนมัติโดยใช้พารามิเตอร์ที่ตั้งไว้ล่วงหน้า หลังจากการบัดกรี ให้รอ 2 วินาที จากนั้นใช้ปากกาดูดเพื่อถอดส่วนประกอบ BGA หลังจากการถอดออก ให้ตรวจสอบแผ่นอิเล็กโทรดว่ามีความเสียหายหรือไม่ เช่น การยกแผ่นอิเล็กโทรด รอยขีดข่วนของวงจร หรือการหลุดออก หากพบความผิดปกติให้แก้ไขทันที
3.การทำความสะอาด BGA และ PCB
- วางกระดานไว้บนโต๊ะทำงาน ใช้หัวแร้งและเปียบัดกรีเพื่อขจัดบัดกรีส่วนเกินออกจากแผ่นอิเล็กโทรด ระวังอย่าดึงแผ่นเพื่อหลีกเลี่ยงความเสียหาย
- หลังจากทำความสะอาดแผ่นอิเล็กโทรดแล้ว ให้ใช้น้ำยาทำความสะอาด PCB และผ้าขี้ริ้วเพื่อทำความสะอาดพื้นผิว หาก CPU จำเป็นต้องทำการลูกบอลซ้ำ ให้ใช้เครื่องทำความสะอาดอัลตราโซนิกพร้อมอุปกรณ์ป้องกันไฟฟ้าสถิตเพื่อทำความสะอาดส่วนประกอบ BGA ก่อนที่จะทำการลูกบอลใหม่
บันทึก:สำหรับอุปกรณ์ไร้สารตะกั่ว อุณหภูมิของหัวแร้งควรอยู่ที่ 340±40 องศา สำหรับแผ่น CBGA และ CCGA อุณหภูมิของหัวแร้งควรอยู่ที่ 370 ± 30 องศา หากอุณหภูมิของหัวแร้งไม่เพียงพอ ควรทำการปรับเปลี่ยนตามสภาวะจริง
4.BGA ชิป Balling
ดีบุกสำหรับชิป BGA ควรทำจากแผ่นเหล็กเจาะด้วยเลเซอร์พร้อมตาข่ายบานด้านเดียว ความหนาของแผ่นควรเป็น 2 มม. และผนังรูควรเรียบ ด้านล่างของรู (ด้านที่สัมผัสกับ BGA) ควรเรียบและไม่มีรอยขีดข่วน ใช้สถานีปรับปรุง BGA วาง BGA บนสเตนซิล เพื่อให้แน่ใจว่ามีการจัดตำแหน่งที่แม่นยำ ลายฉลุควรยึดด้วยบล็อกแม่เหล็ก วางประสานที่หนาขึ้นเล็กน้อยจำนวนเล็กน้อยถูกนำไปใช้กับลายฉลุเพื่อเติมเต็มช่องตาข่ายทั้งหมด จากนั้นแผ่นเหล็กจะถูกยกขึ้นอย่างช้าๆ โดยทิ้งลูกบัดกรีเล็กๆ ไว้บน BGA จากนั้นจะถูกให้ความร้อนอีกครั้งด้วยปืนลมร้อนเพื่อสร้างลูกบอลประสานที่สม่ำเสมอ หากลูกบัดกรีหายไปบนแผ่นแต่ละแผ่น ให้บัดกรีใหม่โดยการกดแผ่นเหล็กอีกครั้ง อย่าให้เหล็กแผ่นร้อนโดยใช้สารบัดกรี เพราะอาจส่งผลต่อความแม่นยำได้
5.BGA ชิปบัดกรี
ใช้ฟลักซ์เล็กน้อยบนลูกบอลบัดกรี BGA และแผ่น PCBA จากนั้นจัดแนว BGA ให้ตรงกับเครื่องหมายดั้งเดิม หลีกเลี่ยงการใช้ฟลักซ์มากเกินไป เนื่องจากอาจทำให้เกิดฟองขัดสนซึ่งอาจขยับชิปได้ วาง PCBA ไว้บนสถานีปรับปรุง BGA โดยจัดตำแหน่งในแนวนอน เลือกหัวฉีดที่เหมาะสม และตั้งหัวฉีดให้อยู่เหนือ BGA 4 มม. ใช้โปรไฟล์อุณหภูมิที่เลือกไว้ล่วงหน้าบนสถานีปรับปรุง BGA ซึ่งจะบัดกรี BGA โดยอัตโนมัติบันทึก:อย่ากด BGA ระหว่างการบัดกรี เนื่องจากอาจทำให้เกิดไฟฟ้าลัดวงจรระหว่างลูกบอลได้ เมื่อลูกบอลบัดกรี BGA ละลาย แรงตึงผิวจะทำให้ชิปอยู่ตรงกลางบน PCBA เมื่อสถานีทำใหม่ทำความร้อนเสร็จแล้ว ก็จะส่งเสียงเตือน อย่าเคลื่อนย้าย PCBA จนกว่า PCBA จะเย็นลงเป็นเวลา 40 วินาที
วี. การตรวจสอบการบัดกรี BGA และการทำความสะอาดบอร์ด PCBA
- หลังจากการบัดกรี ให้ทำความสะอาดส่วนประกอบ BGA และ PCBA โดยใช้น้ำยาทำความสะอาดเพลทเพื่อขจัดฟลักซ์และอนุภาคบัดกรีส่วนเกิน
- ใช้ไฟขยายเพื่อตรวจสอบ BGA และ PCBA โดยตรวจสอบว่าชิปอยู่ตรงกลาง จัดตำแหน่ง และขนานกับ PCBA มองหาบัดกรีล้น การลัดวงจร หรือปัญหาอื่นๆ หากพบความผิดปกติ ให้บัดกรีบริเวณที่ได้รับผลกระทบอีกครั้ง อย่าดำเนินการทดสอบเครื่องจนกว่าการตรวจสอบจะเสร็จสิ้น เพื่อหลีกเลี่ยงการขยายข้อผิดพลาด.












