
สถานีรีบอลลิ่ง BGA Tech
1. เทคโนโลยีล่าสุดในสนามสถานีรีบอล BGA
2. เทคโนโลยีล่าสุดถูกนำมาใช้ในระบบทำความร้อนและระบบจัดตำแหน่งแสง
3. มีในสต็อก! ยินดีต้อนรับสู่การสั่งซื้อ
4. สามารถ reball ชิปที่แตกต่างกันของเมนบอร์ดที่แตกต่างกัน
คำอธิบาย
สถานีรีบอลลิ่ง BGA Tech
เทคโนโลยี BGA reballing ของสถานีหมายถึงกระบวนการเปลี่ยนลูกประสานบนชิป Ball Grid Array (BGA)
BGA เป็นบรรจุภัณฑ์แบบติดพื้นผิวชนิดหนึ่งที่ใช้สำหรับวงจรรวม โดยชิปจะติดตั้งอยู่บน PCB
ใช้อาร์เรย์ของลูกประสานขนาดเล็ก


1. การประยุกต์ใช้เทคโนโลยี BGA Reballing ของสถานีอัตโนมัติ
ทำงานร่วมกับเมนบอร์ดหรือ PCBA ทุกชนิด
บัดกรี, รีบอล, บัดกรีชิปประเภทต่างๆ: BGA, PGA, POP, BQFP, QFN, SOT223, PLCC, TQFP, TDFN, TSOP,
PBGA, CPGA, ชิป LED
2.คุณสมบัติผลิตภัณฑ์ของการรีบอลอัตโนมัติของสถานี BGA Tech

3.ข้อกำหนดของการรีบอลอัตโนมัติของสถานี BGA Tech

4.รายละเอียดของการรีบอลอัตโนมัติของสถานี BGA Tech
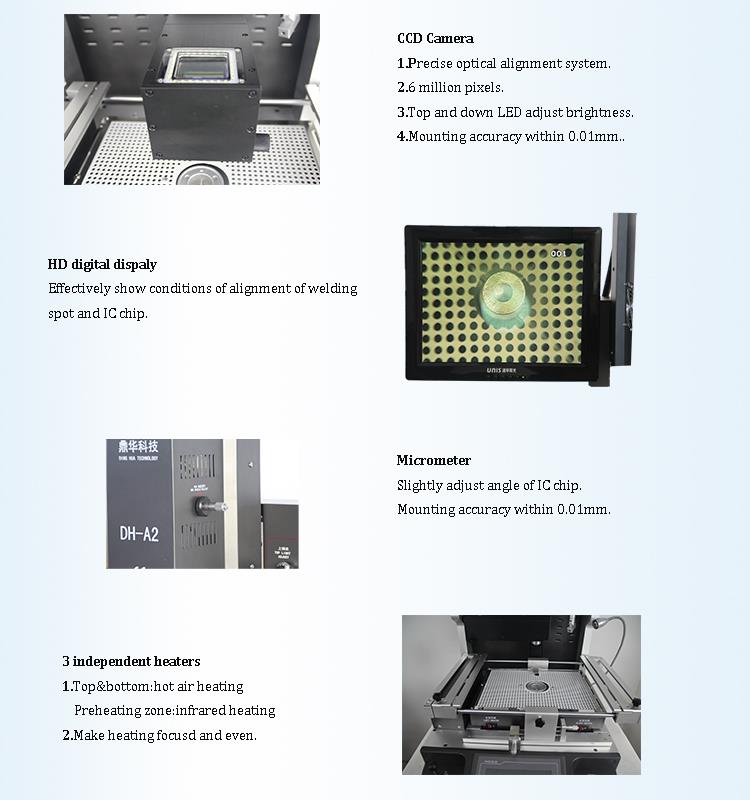

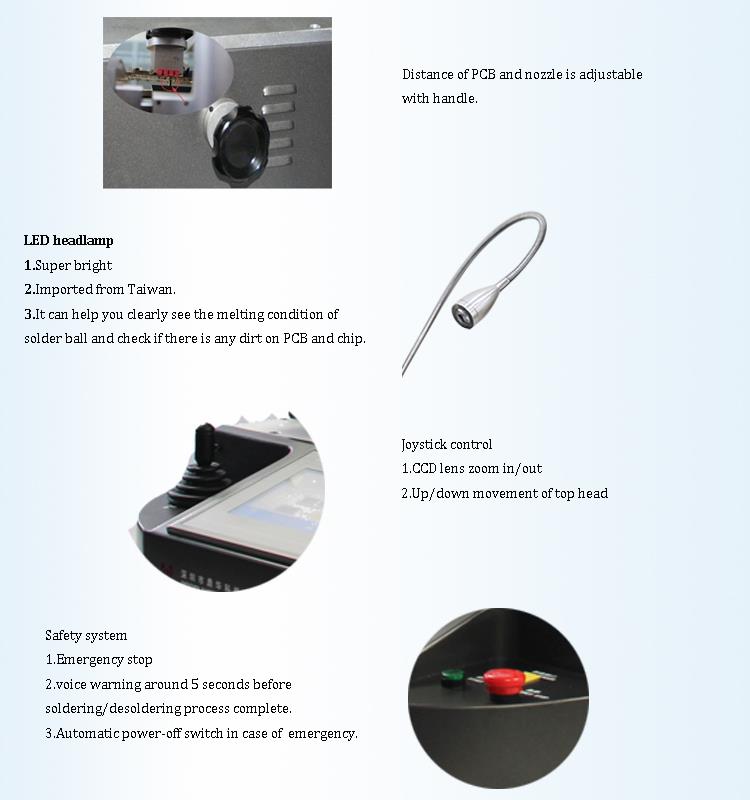
5.ทำไมต้องเลือกของเราการรีบอลอัตโนมัติของสถานี BGA Tech?


6.ใบรับรองของการรีบอลอัตโนมัติของสถานี BGA Tech
ใบรับรอง UL, E-MARK, CCC, FCC, CE ROHS ในขณะเดียวกันเพื่อปรับปรุงและทำให้ระบบคุณภาพสมบูรณ์แบบ
Dinghua ได้ผ่านการรับรองการตรวจสอบในสถานที่ ISO, GMP, FCCA, C-TPAT

7. การบรรจุและการจัดส่งของการรีบอลอัตโนมัติของสถานี BGA Tech

8. จัดส่งสำหรับการรีบอลอัตโนมัติของสถานี BGA Tech
ดีเอชแอล/ทีเอ็นที/เฟดเอ็กซ์ หากคุณต้องการเงื่อนไขการจัดส่งอื่น ๆ โปรดแจ้งให้เราทราบ เราจะสนับสนุนคุณ
9. เงื่อนไขการชำระเงิน
โอนเงินผ่านธนาคาร Western Union บัตรเครดิต
โปรดแจ้งให้เราทราบหากคุณต้องการการสนับสนุนอื่นๆ
10. การสาธิตการทำงานของ Station Reballing BGA Tech?
11. ความรู้ที่เกี่ยวข้อง
กระบวนการ reflow ที่ถูกต้อง:
เทคโนโลยีการบัดกรีแบบ Reflow ไม่ง่ายอย่างที่หลายคนคิด โดยเฉพาะอย่างยิ่งเมื่อคุณต้อง
บรรลุข้อบกพร่องเป็นศูนย์และการรับประกันความน่าเชื่อถือในการเชื่อม (อายุการใช้งาน) ฉันสามารถแบ่งปันประสบการณ์ของฉันกับคุณเท่านั้น
ขณะนี้
เพื่อให้แน่ใจว่ากระบวนการบัดกรี reflow ดี ควรทำสิ่งต่อไปนี้:
1. ทำความเข้าใจเกี่ยวกับคุณภาพและข้อกำหนดในการบัดกรีบน PCBA ของคุณ เช่น อุณหภูมิสูงสุด
ข้อกำหนดและข้อต่อบัดกรีและอุปกรณ์ที่จำเป็นที่สุดสำหรับชีวิต
2. ทำความเข้าใจปัญหาการบัดกรีบน PCBA เช่น ส่วนที่พิมพ์ยาประสาน
ใหญ่กว่าแผ่นรอง, ส่วนที่มีระยะห่างเล็กน้อย, และอื่นๆ ในทำนองเดียวกัน;
3. ค้นหาจุดที่ร้อนที่สุดและเย็นที่สุดบน PCBA และประสานเทอร์โมคัปเปิลที่จุดนั้น
4. กำหนดตำแหน่งอื่นๆ ที่จำเป็นต้องมีการวัดอุณหภูมิของเทอร์โมคัปเปิล เช่น บรรจุภัณฑ์ BGA
และข้อต่อบัดกรีด้านล่าง, ตัวอุปกรณ์ที่ไวต่อความร้อน เป็นต้น (ใช้ช่องวัดอุณหภูมิได้ทั้งหมด
ข้อมูลมากที่สุด)
5. ตั้งค่าพารามิเตอร์เริ่มต้นและเปรียบเทียบกับข้อมูลจำเพาะของกระบวนการ (หมายเหตุ 9) และการปรับแต่ง
6. PCBA ที่บัดกรีได้รับการสังเกตอย่างระมัดระวังภายใต้กล้องจุลทรรศน์เพื่อสังเกตรูปร่างและสภาพพื้นผิว
ของรอยประสาน ระดับการเปียก ทิศทางการไหลของดีบุก สารตกค้าง และลูกประสานบน
PCBA. โดยเฉพาะอย่างยิ่ง ให้ความสำคัญกับปัญหาการเชื่อมที่บันทึกไว้ในจุดที่สองด้านบน โดยทั่วไป
จะไม่มีข้อผิดพลาดในการเชื่อมเกิดขึ้นหลังจากการปรับเปลี่ยนข้างต้น อย่างไรก็ตาม หากมีข้อผิดพลาด สำหรับการวิเคราะห์โหมดความล้มเหลว
ปรับกลไกให้เข้ากับการควบคุมโซนอุณหภูมิบนและล่าง หากไม่มีความผิดให้ตัดสินว่า
เพื่อทำการปรับแต่งอย่างละเอียดจากเส้นโค้งผลลัพธ์และสภาพของรอยประสานบนกระดาน เป้าหมายคือการ
ทำให้กระบวนการเซ็ตมีความเสถียรมากที่สุดและมีความเสี่ยงน้อยที่สุด เมื่อพิจารณาการปรับควรคำนึงถึงเตาเผา
ปัญหาโหลดและปัญหาความเร็วของสายการผลิต เพื่อให้ได้ความสมดุลที่ดีระหว่างคุณภาพและผลผลิต
การปรับเส้นโค้งของกระบวนการข้างต้นจะต้องพิจารณาจากผลิตภัณฑ์จริง การใช้บอร์ดทดสอบสำหรับ
สินค้าจริง ต้นทุนอาจเป็นปัญหา. ผู้ใช้บางคนประกอบบอร์ดที่มีราคาแพงมากซึ่งทำให้ผู้ใช้
ไม่ยอมตรวจวัดอุณหภูมิบ่อยๆ ผู้ใช้ควรประเมินต้นทุนของการว่าจ้างและต้นทุนของ
ปัญหา. นอกจากนี้ยังสามารถประหยัดค่าใช้จ่ายของบอร์ดทดสอบได้ด้วยการใช้ของปลอม เศษบอร์ด และการคัดเลือก
ตำแหน่ง







