สถานีปรับปรุง bga อินฟราเรด
1. อัตราความสำเร็จสูงในการซ่อมชิป
2. ใช้งานง่ายและสะดวก
3. ความร้อนอินฟราเรด ไม่มีความเสียหายต่อ PCB และชิป
คำอธิบาย
คีย์บอร์ดกล้อง BGA Rework Machine
1.Application of Keyboard Camera BGA Rework Machine
เมนบอร์ดของคอมพิวเตอร์ สมาร์ทโฟน แล็ปท็อป MacBook Logic Board กล้องดิจิตอล เครื่องปรับอากาศ ทีวี และอุปกรณ์อิเล็กทรอนิกส์อื่นๆ จากอุตสาหกรรมการแพทย์ อุตสาหกรรมการสื่อสาร อุตสาหกรรมยานยนต์ ฯลฯ
เหมาะสำหรับชิปประเภทต่างๆ: BGA, PGA, POP, BQFP, QFN, SOT223, PLCC, TQFP, TDFN, TSOP, PBGA, CPGA, ชิป LED

2. คุณสมบัติผลิตภัณฑ์ของ Keyboard Camera BGA Rework Machine

(1) การควบคุมอุณหภูมิที่แม่นยำ
(2) อัตราความสำเร็จสูงในการซ่อมชิป
(3) พื้นที่ทำความร้อนอินฟราเรดสองแห่งเพิ่มอุณหภูมิทีละน้อย
(4) ไม่มีความเสียหายต่อชิปและ PCB
(5) การรับรอง CE รับประกัน
(6) ระบบคำใบ้เสียง: มีเสียงเตือน 5 วินาที-10วินาทีก่อนที่เครื่องทำความร้อนจะเสร็จสิ้น เพื่อเตรียมผู้ปฏิบัติงานให้พร้อม
(7) V-groove PCB ทำงานเพื่อการวางตำแหน่งที่รวดเร็วสะดวกและแม่นยำซึ่งสามารถตอบสนองตำแหน่งบอร์ด PCB ทุกประเภท
(8) V-groove PCB ทำงานเพื่อการวางตำแหน่งที่รวดเร็วสะดวกและแม่นยำซึ่งสามารถตอบสนองตำแหน่งบอร์ด PCB ทุกประเภท
3.Specification of Keyboard Camera BGA Rework Machine
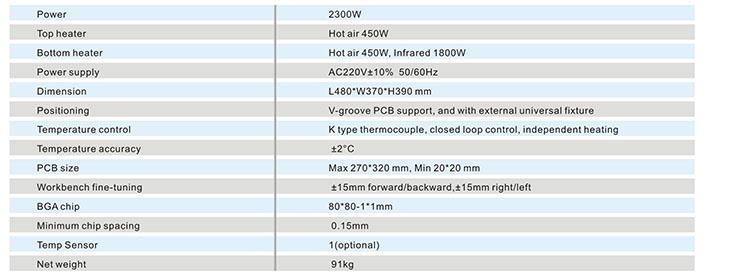
4.รายละเอียดของ Keyboard Camera BGA Rework Machine
1. โซนความร้อนอินฟราเรดสองโซน ;
2.ไฟหน้า LED;
3. แผงควบคุมการทำงาน
4. แถบจำกัด

5. ใบรับรองเครื่องคีย์บอร์ด BGA Rework Machine

6. การบรรจุและจัดส่งเครื่องคีย์บอร์ด BGA Rework Machine

7. ความรู้ที่เกี่ยวข้อง
กระบวนการบรรจุภัณฑ์ BGA
ในปี 1990 ด้วยความก้าวหน้าของเทคโนโลยีการรวม การปรับปรุงอุปกรณ์ และการใช้เทคโนโลยี Deep submicron ความน่าเชื่อถือของวงจรรวมแบบ Ultra Deep Submicron เกิดขึ้นทีละตัว การรวมชิปซิลิกอนตัวเดียว เมื่อระดับของการปรับปรุงอย่างต่อเนื่อง ข้อกำหนดสำหรับบรรจุภัณฑ์วงจรรวมมีความเข้มงวดมากขึ้น
จำนวนพิน I/O เพิ่มขึ้นอย่างมาก และการใช้พลังงานก็เพิ่มขึ้นเช่นกัน เพื่อตอบสนองความต้องการในการพัฒนา จึงได้มีการเพิ่มแพ็คเกจ Ball Grid Array รูปแบบใหม่ ย่อว่า BGA (Ball Grid Array Package)
ประเภทแพ็คเกจ
(1) คุณสมบัติของแพ็คเกจ BGA
เมื่อ BGA ปรากฏขึ้น ก็กลายเป็นตัวเลือกที่ดีที่สุดสำหรับแพ็คเกจพินที่มีความหนาแน่นสูง ประสิทธิภาพสูง อเนกประสงค์ และ I/O สูงสำหรับชิป VLSI เช่น CPU และเหนือและใต้
สะพาน คุณสมบัติของมันคือ:
(1) แม้ว่าจำนวนพิน I/O จะเพิ่มขึ้น แต่ระยะพิทช์ของพินนั้นใหญ่กว่า QFP มาก ซึ่งช่วยเพิ่มผลผลิตของแอสเซมบลี
(2) แม้ว่าการใช้พลังงานจะเพิ่มขึ้น แต่ BGA สามารถควบคุมได้โดยวิธีชิปยุบแบบควบคุม ซึ่งเรียกสั้น ๆ ว่าการเชื่อม C4 ซึ่งสามารถปรับปรุงประสิทธิภาพของอิเล็กโทรเทอร์มอลได้
(3) เหมาะสำหรับการผลิตเชิงอุตสาหกรรม เทคโนโลยี C4 ที่ควบคุมการยุบตัวของชิป












