
เครื่องรีบอลรีบอลกริดอาร์เรย์
เครื่องรีบอลรีบอลกริดอาร์เรย์ แพ็คเกจ Ball grid Array เป็นวิธีการบรรจุที่ได้รับความนิยมมากที่สุดในอุตสาหกรรม SMT สถานีปรับปรุง BGA แบบออปติคัลอัตโนมัติ DH-A2E พร้อมระบบการจัดตำแหน่งแบบออปติคอล
คำอธิบาย
เครื่อง Reball Rework Ball Grid Array อัตโนมัติ


1.คุณสมบัติผลิตภัณฑ์ของเครื่อง Reball Rework Ball Grid Array อัตโนมัติ
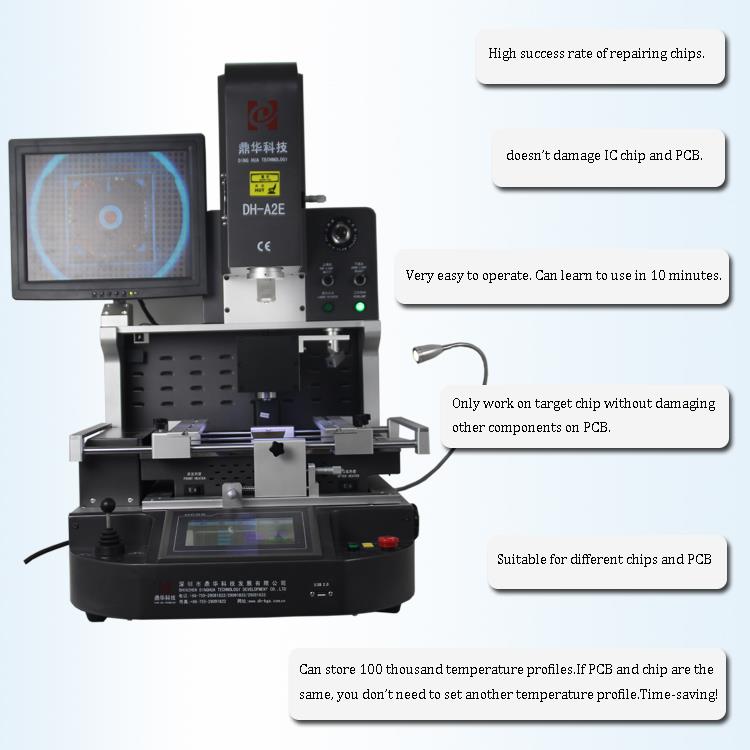
• อัตราความสำเร็จในการซ่อมระดับชิปสูง กระบวนการถอดบัดกรี ติดตั้ง และบัดกรีเป็นไปโดยอัตโนมัติ
• การจัดตำแหน่งที่สะดวก
• การทำความร้อนด้วยอุณหภูมิอิสระสามระดับ + ปรับการตั้งค่า PID ด้วยตนเอง ความแม่นยำของอุณหภูมิจะอยู่ที่ ±1 องศา
•ปั๊มสุญญากาศในตัว หยิบและวางชิป BGA
•ฟังก์ชั่นทำความเย็นอัตโนมัติ
2. ข้อกำหนดของเครื่อง Reball Rework Ball Grid Array แบบอัตโนมัติ
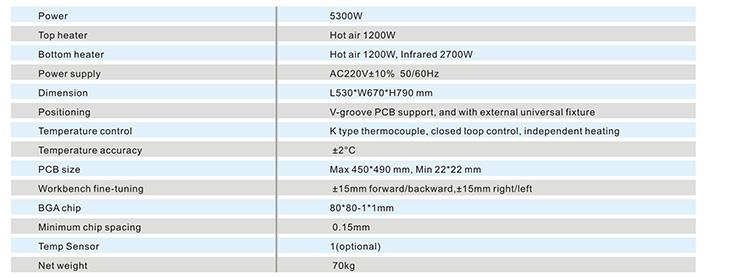
3.รายละเอียดของเครื่อง Reball Reball อาร์เรย์ลูกกริดอัตโนมัติลมร้อน

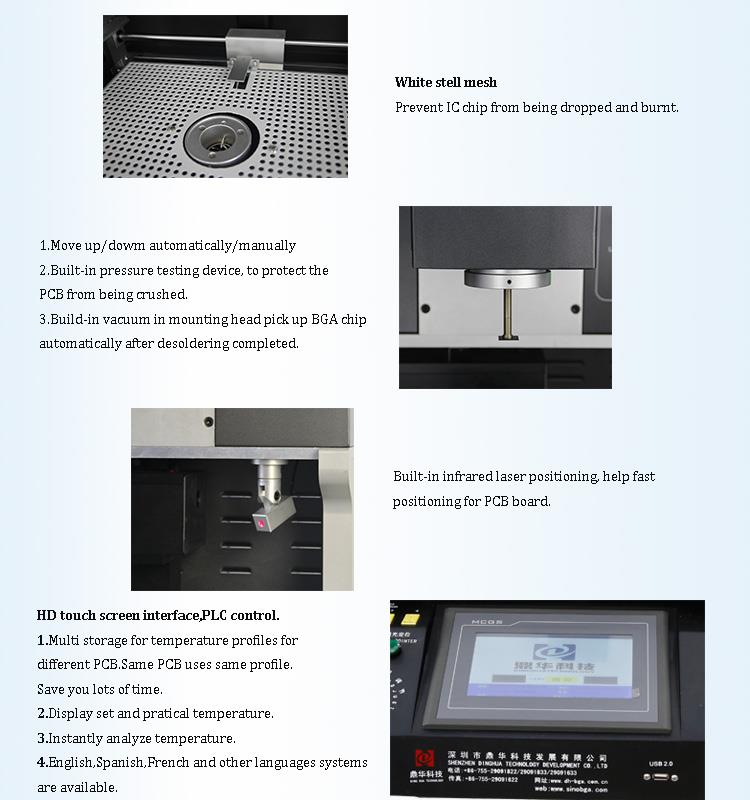
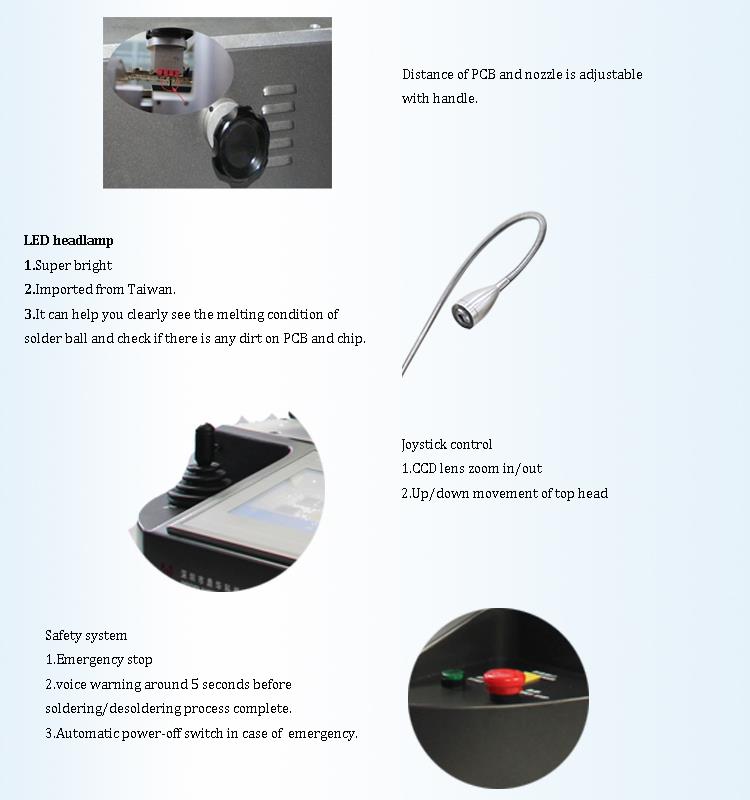
4. เหตุใดจึงเลือกเครื่องรีบอลรีบอลกริดอาร์เรย์อัตโนมัติแบบอินฟราเรดของเรา


5. ใบรับรองการจัดตำแหน่งด้วยแสงอัตโนมัติ Ball Grid Array Rework Reball Machine

6.รายการบรรจุภัณฑ์ของ Optics จัดตำแหน่งเครื่อง Reball Reball ของกล้อง CCD Ball Grid Array

7. การจัดส่งเครื่อง Reball Rework Ball Grid Array แบบอัตโนมัติแบบแยกส่วน
เราจัดส่งเครื่องผ่าน DHL/TNT/UPS/FEDEX ซึ่งรวดเร็วและปลอดภัย หากคุณต้องการเงื่อนไขการจัดส่งอื่น ๆ
โปรดแจ้งให้เราทราบ
8. เงื่อนไขการชำระเงิน
โอนเงินผ่านธนาคาร, Western Union, บัตรเครดิต
เราจะส่งเครื่องกับธุรกิจ 5-10 หลังจากได้รับการชำระเงินแล้ว
9. ติดต่อเราเพื่อตอบกลับทันทีและราคาที่ดีที่สุด
Email:john@dh-kc.com
MOB/WhatsApp/Wechat: +86 15768114827
คลิกลิงก์เพื่อเพิ่ม WhatsApp ของฉัน:
https://api.whatsapp.com/send?phone=8615768114827
10. ความรู้ที่เกี่ยวข้องเกี่ยวกับเครื่องรีเวิร์ค/รีบอลอัตโนมัติ Ball Grid Array (BGA)
มาตรฐานคุณภาพการบัดกรี FPC SMT:
- การกวาดล้างขั้นต่ำตามปกติ: ขนาดส่วนประกอบต้องเกินแผ่น 20µm
- ตำแหน่งการเชื่อม: ควรมีระยะห่าง 1/2 ของตำแหน่งการเชื่อม
4. ข้อกำหนดสำหรับการตรวจสอบชิ้นส่วนที่เชื่อม:
| เลขที่ | รายการตรวจสอบ | มาตรฐานการตรวจสอบ | ไอคอนไม่ดี |
|---|---|---|---|
| 4.1 | ชิ้นส่วนที่ขาดหายไป | ไม่ควรมีชิ้นส่วนที่ไม่ได้เชื่อมหรือชิ้นส่วนหลุดออกจากข้อต่อประสาน FPC | เลขที่ |
| 4.2 | ความเสียหาย | ส่วนประกอบหลังการเชื่อมต้องไม่เสียหายหรือมีรอยบาก | เลขที่ |
| 4.3 | ชิ้นส่วนที่ไม่ถูกต้อง | ข้อมูลจำเพาะของรุ่นส่วนประกอบที่บัดกรีกับแผ่นอิเล็กโทรดจะต้องตรงกับแบบทางวิศวกรรม | เลขที่ |
| 4.4 | ขั้ว | ทิศทางของชิ้นส่วนที่เชื่อมต้องตรงกับคำแนะนำของบอร์ดหรือแบบทางวิศวกรรม | เลขที่ |
| 4.5 | เบ็ดเตล็ด | ไม่ควรมีกาว คราบดีบุก หรือเศษอื่นๆ เหลืออยู่ในหมุดของส่วนประกอบ | เลขที่ |
| 4.6 | ฟองสบู่ | บรรจุภัณฑ์ของส่วนประกอบที่บัดกรีจะต้องไม่มีฟองที่ไม่ดี | เลขที่ |
5.1 การเชื่อมต่อเนื่อง
ไม่ควรมีการลัดวงจรระหว่างข้อต่อบัดกรี
5.2 รอยเชื่อม
ชิ้นส่วนที่เชื่อมจะต้องไม่มีข้อต่อที่ไม่ได้เชื่อมต่อกับจุดบัดกรี
5.3 บัดกรีที่ไม่สามารถหลอมละลายได้
ชิ้นส่วนต้องไม่มีข้อต่อบัดกรีที่ไม่สมบูรณ์หรือขาดหายไป
5.4 ลอยตัว:
- 5.4.1: ความสูงของแผ่นบัดกรีที่ด้านล่างของพินตัวเชื่อมต่อต้องไม่เกินความสูงของพินชิ้นส่วน (หมายเหตุ: ดังแสดงในรูปที่ T ความสูงของพินชิ้นส่วนคือ G ความสูงของดีบุกแผ่นบัดกรีคือ T และความสูงของแผ่นบัดกรีในระหว่างการบัดกรีต้องไม่เกินความสูงของพินชิ้นส่วน กล่าวคือ G น้อยกว่าหรือ เท่ากับต.)
- 5.4.2: ความสูงของแผ่นบัดกรีที่ด้านล่างของตัวต้านทาน, LED ฯลฯ ไม่ควรสูงกว่า 1/2 ของความสูงของตะกั่วส่วนประกอบ
5.5 การขาดบัดกรี:
- 5.5.1: ความสูงของดีบุกบนขั้วต่อจะต้องเป็น 2/3 ของความสูงของพินและต้องไม่เกินความสูงที่ชิ้นส่วนพลาสติกมาบรรจบกัน (หมายเหตุ: ดังแสดงในรูปที่ T ความสูงของพินชิ้นส่วนคือ G ความสูงของแผ่นบัดกรีดีบุกคือ T และ F คือความสูงของจุดบัดกรีปกติ ดังนั้น F มากกว่าหรือเท่ากับ G {{2} }/3ต.)
- 5.5.2: ตัวนำของตัวต้านทาน, LED และชิ้นส่วนอื่นๆ ต้องมีบัดกรีอย่างน้อย 2/3 ของความสูงของพิน
สินค้าที่เกี่ยวข้อง:
- เครื่องบัดกรี Reflow อากาศร้อน
- เครื่องซ่อมเมนบอร์ด
- โซลูชันส่วนประกอบไมโคร SMD
- เครื่องบัดกรี LED SMT Rework
- เครื่องเปลี่ยนไอซี
- เครื่องรีบอลชิป BGA
- การรีบอล BGA
- อุปกรณ์บัดกรีและบัดกรี
- เครื่องกำจัดชิป IC
- เครื่องรีเวิร์ก BGA
- เครื่องบัดกรีอากาศร้อน
- สถานีปรับปรุง SMD
- อุปกรณ์ถอดไอซี







